При изготовлении полупроводниковых ИС требуется неоднократное проведение фотолитографического процесса с воспроизведением на пластине совмещающихся между собой различных рисунков. Для этого обычно используется набор из 7—8 фотошаблонов. Проектирование и изготовление фотошаблонов требует особо высокой точности и соблюдения в производственных цехах условий вакуумной гигиены (не более 3—5 пылинок размером около 0,5 мкм на 1 л воздуха): для получения сотен элементов микронных размеров в сотнях идентичных ИС, изготавливаемых одновременно на одной ПП пластине, фотошаблоны должны обеспечивать воспроизводимость размеров от одного рисунка к другому и их взаимную совмещаемость. Поэтому при проектировании и изготовлении фотошаблонов используется сложное прецизионное оборудование: координатографы с программным управлением от ЭВМ для вычерчивания оригинала рисунка с увеличением в сотни раз; различной конструкции фотоштампы для уменьшения рисунка-оригинала и его мультиплицирования (размножения).
Для формирования структур элементов в исходной ПП пластине проводится легирование примесями участков, подготовленных на этапе фотолитографии. Основным методом легирования является диффузия, например при помещении пластины кремния на некоторое время в пары примеси при температуре 1100—1200 °С. Точность поддержания температуры, постоянство концентрации примеси у поверхности пластины, длительность процесса определяют распределение примеси по толщине пластины и соответственно параметры формируемого элемента. Кроме диффузии, легирование может производиться ионным внедрением (бомбардировкой пластины ионизированными атомами примеси), которое является новым технологическим направлением, дополняющим и частично заменяющим диффузию. Полупроводниковые ИС имеют высокий уровень интеграции (до 10 000 элементов и более в одном ПП кристалле).
Совершенствование технологии изготовления активных (диодных и транзисторных) элементов на пластинах ПП материала путём перехода на групповые методы стимулировало развитие техники печатного монтажа и плёночной технологии создания пассивных (резистивных, ёмкостных) микроминиатюрных компонентов, что послужило основой для разработки плёночных ИС. Плёночные ИС, как правило, являются чисто пассивными, т. к. нанесение монокристаллических ПП плёнок для формирования активных элементов не обеспечивает необходимого их качества. Основой для плёночной ИС служит диэлектрическая, например керамическая, подложка. Различают толстоплёночную технологию изготовления ИС — нанесение слоев проводящих, резистивных и диэлектрических паст толщиной от 1 до 25 мкм и тонкоплёночную технологию — вакуумное напыление плёнок толщиной до 1 мкм через металлические трафареты или вакуумное напыление в сочетании с последующей фотолитографической обработкой.
Плёночная ИС со смонтированными на ней бескорпусными дискретными ПП приборами (диодами, транзисторами) и бескорпусными полупроводниковыми ИС называется гибридной ИС (рис. 3 ). Её пассивная часть может быть выполнена многослойной, в виде набора керамических подложек со слоями плёночных элементов. После спекания подложек получается монолит с многослойным расположением электрически соединённых между собой пассивных элементов. Бескорпусные активные элементы монтируются на верхней поверхности монолита.
Кроме полупроводниковых и плёночных ИС, изготавливают т. н. совмещенные ИС. Активные элементы в них выполняются в объёме ПП подложки по планарно-эпитаксиальной технологии, а пассивные элементы и электрические соединения наносятся в виде тонких плёнок на поверхность монолитной структуры. По уровню интеграции совмещенные ИС приближаются к полупроводниковым.
Изготавливают также многокристальные ИС с высоким уровнем интеграции, в которых несколько кристаллов полупроводниковых ИС объединяются на диэлектрической подложке плёночными соединениями в сложнейшее электронное устройство. Его функциональное назначение может соответствовать отдельному блоку или даже системе, например вычислительной машине настольного типа.
Сочетание плёночной технологии получения пассивных элементов и использование в качестве активных элементов электровакуумных приборов в микроминиатюрном исполнении привело к появлению вакуумных ИС и нового направления — вакуумной микроэлектроники. Вакуумная ИС может быть выполнена как в виде плёночной ИС с навесными микроминиатюрными электровакуумными приборами, так и в виде устройства, все компоненты которого помещены в вакуум. В отличие от ПП ИС вакуумные ИС имеют повышенную стойкость к воздействию космического излучения; их плотность упаковки достигает 20—30 элементов в 1 см3 .
Все виды ИС по функциональному признаку делятся на 2 больших класса: цифровые (логические) ИС и линейные ИС. Цифровые ИС предназначены для работы в логических устройствах, в частности они применяются в ЭВМ. К линейным относятся все остальные ИС, предназначенные в основном для линейного (в конечном счёте) преобразования электрических сигналов (усиления, модуляции, детектирования и т. д.), хотя они могут включать в себя такие нелинейные элементы, как генераторы синусоидальных колебаний, преобразователи частоты и др.
Дальнейшее развитие М. идёт главным образом в двух направлениях: повышение уровня интеграции и плотности упаковки в ИС, ставших традиционными; изыскание новых физических принципов и явлений для создания электронных устройств со схемотехническим или даже системотехническим функциональным назначением. Первое направление привело к уровням интеграции, характеризующимся многими тысячами элементов в одном корпусе ИС с микронными и субмикронными размерами отдельных элементов. Второе направление может позволить отказаться от дальнейшего повышения уровня интеграции ИС (из-за конструктивной сложности), снизить рассеиваемую мощность, увеличить быстродействие аппаратуры и др. Это новое направление в целом приобретает название функциональной микроэлектроники — электроники комбинированных сред с использованием таких явлений, как оптические явления в твёрдом теле (оптоэлектроника) и взаимодействие потока электронов с акустическими волнами в твёрдом теле (акустоэлектроника), а также с использованием свойств сверхпроводников, свойств магнетиков и полупроводников в магнитных полупроводниках (магнетоэлектроника) и др.
Лит.: Интегральные схемы, пер. с англ., М., 1970; Микроэлектроника. Сб. ст., в. 1—5, М., 1967—72.
А. А. Васенков, И. Е. Ефимов.
Рис. 3. Гибридная интегральная схема со снятой крышкой корпуса (2 идентичных операционных усилителя с 33 компонентами в каждом). На основании корпуса размещена керамическая подложка размером 29´39 мм с выполненными на ней тонкоплёночными резисторами (1) и соединительными токоведущими дорожками (2); к контактным площадкам (3) плёночной интегральной схемы подсоединены навесные элементы — бескорпусные транзисторы (4), конденсаторы (5); внешние контактные площадки (6) интегральной схемы соединены с выводами корпуса (7).
Рис. 1а. Кремниевая пластина диаметром 60 мм с изготовленными на ней ~2000 одинаковых структур интегральных схем: дефектные структуры на пластине помечены краской (точки и штрихи).
Рис. 1б. Кремниевая пластина. Показан в увеличенном виде кристалл с отдельной структурой; его размеры 1,2´1,2 мм . 1 — соединительная токоведущая дорожка; 2 — диод; 3 — резистор; 4 — контактная площадка; 5 — транзистор.
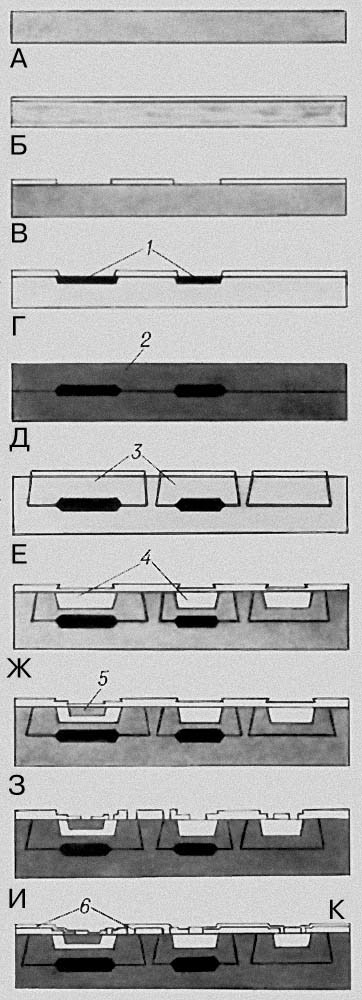
Рис. 2. Последовательность основных технологических операций одного из способов изготовления полупроводниковых ИС: А — подготовка (шлифовка, полировка) пластины кремния с проводимостью n -типа; Б — окисление кремния в атмосфере сухого кислорода; В — фотолитография (фотогравировка слоя окисла кремния, вскрытие «окон» в нём); Г — диффузия сурьмы или мышьяка через «окна» в окисле для получения высокопроводящей области «скрытого» слоя кремния n -типа (1) под коллектором будущего транзистора и базой диода; Д — эпитаксиальное наращивание кремния — нанесение слоя кремния n -типа (2): Е — изолирующая диффузия для получения взаимной электрической изоляции будущих элементов интегральной схемы (ей предшествует окисление эпитаксиального слоя и селективное удаление окисной плёнки с помощью фотолитографии) — диффузия бора, в результате которой эпитаксиальный слой разделяется на отдельные островки кремния n-типа (3), окруженные кремнием р -типа; Ж, З — формирование элементов интегральной схемы в изолированных областях кремния последовательным проведением ещё двух диффузий примесей через вскрываемые с помощью фотолитографии «окна» в дополнительно нанесённой окисной плёнке кремния [вторая диффузия — диффузия бора — производится для создания базовых областей (4) транзисторов, p -n -переходов и областей резисторов, при третьей диффузии — диффузии фосфора — формируются эмиттерные области транзисторов (5)]; И — вскрытие «окон» в окисле кремния под контакты с областями коллектора, эмиттера и базы транзисторов, р - и n - областями диодов и с резисторами; К — создание внутрисхемных соединений посредством вакуумного напыления на поверхность пластины плёнки алюминия, которая затем селективно травится с помощью фотолитографии; сохранённые участки алюминия (6) образуют электроды элементов, соединительные дорожки и контактные площадки для подсоединения структуры интегральной схемы к выводам корпуса.